技術介紹
精材科技是全球首家將晶圓級尺寸封裝商業化的半導體後段封裝公司。從早期的「晶圓級CMOS影像感測器封裝」起步,精材科技已將服務範圍擴展至多樣化的 感測器封裝領域,包含光學元件,微機電系統和客製化晶圓級結構。這些技術可廣泛應用於消費性電子、通訊、電腦、工業應用以及車用電子。
光學感測器服務項目
- 晶片尺寸封裝(CSP)
- 提供兩種類型的RDL互連技術: 側壁互連(XinPac)與穿矽通孔(XinTSV).
- 多種玻璃厚度與濾光片選項,例如雙層AR(抗反射)、IR(紅 外)/AR(抗反射)等。
- 玻璃與晶圓貼合,可有腔體或無腔體。.
- 晶圓重組(RW)
- 提供正照式感測器/背照式感測器/堆疊晶圓等重組服務,應用於行動裝 置、車用和 消費性產品。
- 特殊晶圓重組服務: XinLid-a-G
- 提供用於車用應用的「玻璃蓋板」晶圓重組服務,可在後續組裝製程中保護 晶圓免於微粒汙染。
精材科技技術方案: 光學感測器
| 影像感測器 | 近紅外/環境光/其他 | |||
|---|---|---|---|---|
| 車用 | 行動裝置 | 工業 / 醫療 | 行動、穿戴裝置 / ARVR | |
| VGA >2M | 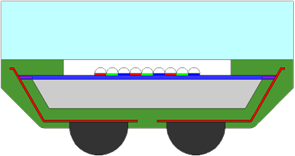 XinPac-a-G |
 XinPac-G |
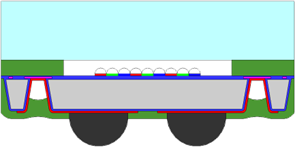 XinTSV-1-G |
 XinPac-OP |
| >8M & >48M |  XinLid-a-G>=8M  |
 堆疊晶圓重組>=48M  |
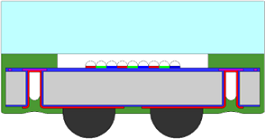 XinTSV-3-G  |
 XinTSV-3-OP  XinPac-D  |