微機電(MEMS)應用服務項目
- XinLid-S
- 晶圓薄化與貼合晶圓之局部切割製程。透過局部切割方式露出鍵合墊,利於 後續封裝與連接。
- 晶片尺寸封裝(CSP)
- 採用後做通孔(Via Last TSV) 技術將晶圓正面的焊電訊號導引至背面,提升封裝彈性與整合度。
- 特殊製程能力: 大型腔體成形與應力釋放
- 以乾式蝕刻方式加工矽晶圓,形成超大型腔體結構以滿足高效能產品需求, 例如MEMS揚聲器等應用。
精材科技技術方案: MEMS 感測器
| 晶圓進件 | 晶圓及封裝 | 元件封裝 | 終端應用 | |
|---|---|---|---|---|
| 慣性 微機電 |    |
 XinLid-S   XinLid-S |
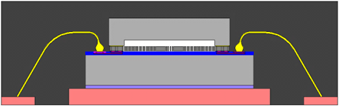 QFN  XinTSV-B 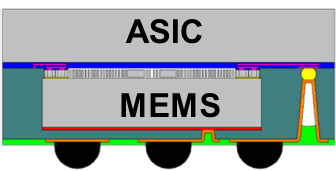 MEMS-CSP |
  |
| 噴墨印表機 | 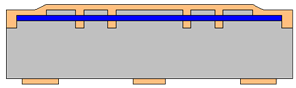 |
 |
 |
|
| 揚聲器 |  |
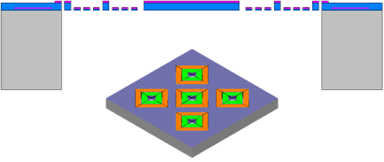 |
 |
 |